随着大规模集成电路的发展,集成度不断提高,线宽不断减小,对硅片的表面质量要求也越来越严格。这主要是因为抛光硅片表面的颗粒和金属杂质沾污会严重影响器件的质量和成品率。据报道,对于线宽为0.35 μm的64M DRAM器件,影响电路的临界颗粒尺寸为0.06 μm,硅片表面大于0.2 μm的颗粒数应小于20个/片。
颗粒沾污的危害:
(1) 图形缺陷
(2)离子注入不良
(3)MOS晶体管特性不稳定
测试方法:
使用扫描表面检查系统对硅片进行局部光散射体进行测试,得到硅片表面的颗粒度情况
测试范围:
硅抛光片,外延片
测试标准:
GB/T 19921-2018
样品要求:
(1)200 mm硅片厚度725 μm
(2)300 mm硅片厚度775 μm
(3)450 mm硅片厚度925 μm
检测缺陷类型:
聚苯乙烯乳胶球,颗粒,晶体原生凹坑,小丘,钉,堆积层错,划伤,滑移线,凹坑,雾,残留抛光液,色斑
测试设备:KLA-Tencor CS 920
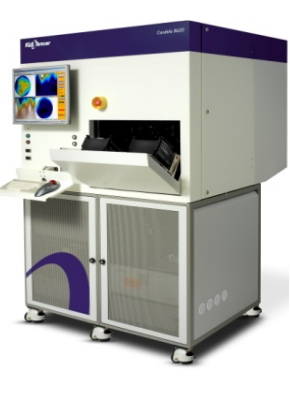
设备特点:
(1)单次扫描中结合四种光学检测方法的单机解决方案,可实现最高效的自动化缺陷侦测与分类
(2)对LED材料的缺陷进行自动检测,从而增强衬底的质量控制,迅速确定造成缺陷的根本原因并改进MOCVD质量控制
(3)满足多种工业要求,包括高亮度发光二极管(HBLED)、高功率射频(RF)电子装置及玻璃展柜等技术
(4)采用高级算法,可处理各种材料超过30个DOIs的缺陷分类
对于SiC wafer,测量精度可以达到100 nm,而Silicon wafer可以达到60 nm。
 实验外包
实验外包
 方案定制
方案定制
 仪器预约
仪器预约
 技术研发
技术研发
